Broadcom представила гигантскую 3,5-дюймовую платформу XDSiP для AI XPU
 Broadcom Inc. — американская компания по разработке полупроводниковой продукции и программного обеспечения со штаб-квартирой в Пало-Алто (Калифорния, США). На счету компании более 15 400 патентов. Википедия
Broadcom Inc. — американская компания по разработке полупроводниковой продукции и программного обеспечения со штаб-квартирой в Пало-Алто (Калифорния, США). На счету компании более 15 400 патентов. Википедия
Читайте также:OpenAI разрабатывает свой первый чип ИИ в сотрудничестве с Broadcom и TSMCBroadcom разочарована техпроцессом Intel 18AOpenAI обсуждает с Broadcom создание чипов для ИИРазрабатывается межсоединение ускорителя ИИ с открытым стандартомBroadcom продемонстрировала гигантский ИИ-чип
 TSMC (аббревиатура от англ. Taiwan Semiconductor Manufacturing Company) — тайваньская компания, занимающаяся изучением и производством полупроводниковых изделий. Основана в 1987 году правительством Китайской республики и частными инвесторами.
Штаб-квартира TSMC находится в г. Википедия
TSMC (аббревиатура от англ. Taiwan Semiconductor Manufacturing Company) — тайваньская компания, занимающаяся изучением и производством полупроводниковых изделий. Основана в 1987 году правительством Китайской республики и частными инвесторами.
Штаб-квартира TSMC находится в г. Википедия
Читайте также:Arm сократила рабочие места из-за ограничений TSMCПроцесс N2 от TSMC имеет большое преимущество перед 18A от Intel: плотность SRAMTSMC повысила производительность на 6% до 2 нмИнтерпозер CoWoS TSMC Super Carrier увеличиваетсяОбновление TSMC 1.6 нм: ощутимые улучшения, но возникают новые проблемы
В 3,5-дюймовом XDSiP от Broadcom используется технология упаковки TSMC CoWoS-L, которая обеспечивает максимальный размер промежуточного устройства, примерно в 5,5 раз превышающий размер сетки (около 858 мм ^ 2), или 4719 мм ^ 2 для вычислительных микросхем, микросхем ввода-вывода и до 12 пакетов HBM3/HBM4. Для достижения максимальной производительности Broadcom предлагает разделить конструкцию вычислительных чиплетов и расположить один логический чиплет поверх другого способом «лицом к лицу» (F2F), используя гибридное медное соединение (HCB).
Этот подход к укладке «лицом к лицу» (F2F), который напрямую соединяет верхние металлические слои верхней и нижней кремниевых матриц с помощью гибридного медного соединения без зазоров, является ключевым преимуществом платформы Broadcom 3D XDSiP по сравнению с подходом «лицом к лицу», который основан на использовании сквозных кремниевых переходов (TSV). Подход F2F обеспечивает до 7 раз большее количество соединений для передачи сигналов и более короткую маршрутизацию сигналов, снижает энергопотребление в интерфейсах типа «матрица-матрица» на 90%, минимизирует задержку в 3D-стеке и обеспечивает дополнительную гибкость для проектных групп при разделении архитектуры ASIC между верхней и нижней матрицами (что является результатом более плотной соединения и меньшие задержки), по данным Broadcom.
Изображение: Broadcom
"В тесном сотрудничестве с нашими заказчиками мы создали платформу 3.5D XDSiP на основе технологий и инструментов от TSMC и EDA partners", - сказал Фрэнк Остойич, старший вице-президент и генеральный менеджер подразделения ASIC-продуктов Broadcom. - Благодаря вертикальному размещению компонентов микросхемы платформа Broadcom 3.5D позволяет разработчикам микросхем сочетать правильные процессы изготовления для каждого компонента, уменьшая при этом размер промежуточного устройства и упаковки, что приводит к значительному повышению производительности, эффективности и стоимости".
В пресс-релизе компании не упоминаются методы 3D-укладки упаковки TSMC. Тем не менее, 3.5D XDSiP F2F HCB, скорее всего, является запатентованной реализацией технологии укладки SoIC-X, разработанной TSMC, хотя и с использованием запатентованного Broadcom дизайна и процесса автоматизации (что косвенно подтверждается Кевином Чжаном из TSMC). Поскольку платформа использует как интеграцию 2.5D, так и 3D-стек, Broadcom называет ее "3.5D".
Изображение: Broadcom
"TSMC и Broadcom тесно сотрудничали на протяжении последних нескольких лет, чтобы объединить самые передовые логические процессы TSMC и технологии 3D-сборки чипов с опытом Broadcom в области проектирования", - сказал доктор Кевин Чжан, старший вице-президент по развитию бизнеса и глобальным продажам и заместитель главного операционного директора TSMC.
Broadcom собирается использовать свою систему 3.5D eXtreme Dimension System в качестве платформы для создания пользовательских процессоров AI/HPC и ASIC, которые она разрабатывает для таких компаний, как Google, Meta и OpenAI, предъявляющих безграничные требования к производительности. В рамках этой платформы Broadcom предложит широкий набор IP-адресов, включая HBM PHY, PCIe и GbE; чип-платы с полным набором решений и даже кремниевую фотонику, что позволит клиентам сосредоточиться на основной составляющей своих процессоров - архитектуре процессорных блоков.
Ведущий продукт Broadcom 3.5D XDSiP сочетает в себе четыре вычислительных матрицы, изготовленных по передовому технологическому процессу TSMC (N2), одну матрицу ввода-вывода и шесть модулей HBM.
Изображение: Broadcom
 Fujitsu Limited (яп. 富士通株式会社, Фудзицу кабусикигайся) (TYO: 6702) — крупная японская корпорация, производитель электроники и ИТ-компания. Работает на глобальном уровне, имеет дочерние подразделения во всём мире. Википедия
Fujitsu Limited (яп. 富士通株式会社, Фудзицу кабусикигайся) (TYO: 6702) — крупная японская корпорация, производитель электроники и ИТ-компания. Работает на глобальном уровне, имеет дочерние подразделения во всём мире. Википедия
Читайте также:AMD и Fujitsu создают платформы для ИИ и HPCFujitsu и Supermicro разрабатывают серверы с жидкостным охлаждением на базе Arm к 2027 гFujitsu использует суперкомпьютер Fugaku для обучения LLM с 13 миллиардами параметров
Изображение: Broadcom
"Благодаря более чем десятилетнему сотрудничеству Fujitsu и Broadcom успешно вывели на рынок несколько поколений высокопроизводительных вычислительных систем ASIC, - сказал Наоки Синдзе, старший вице-президент и руководитель отдела разработки передовых технологий Fujitsu. - Новейшая платформа Broadcom 3.5D позволяет использовать 2-нанометровый Arm-процессор нового поколения Fujitsu-Monaka на базе технологии Fujitsu-Monaka для достижения высокой производительности, низкого энергопотребления и снижения стоимости".
Источник: Tomshardware.com


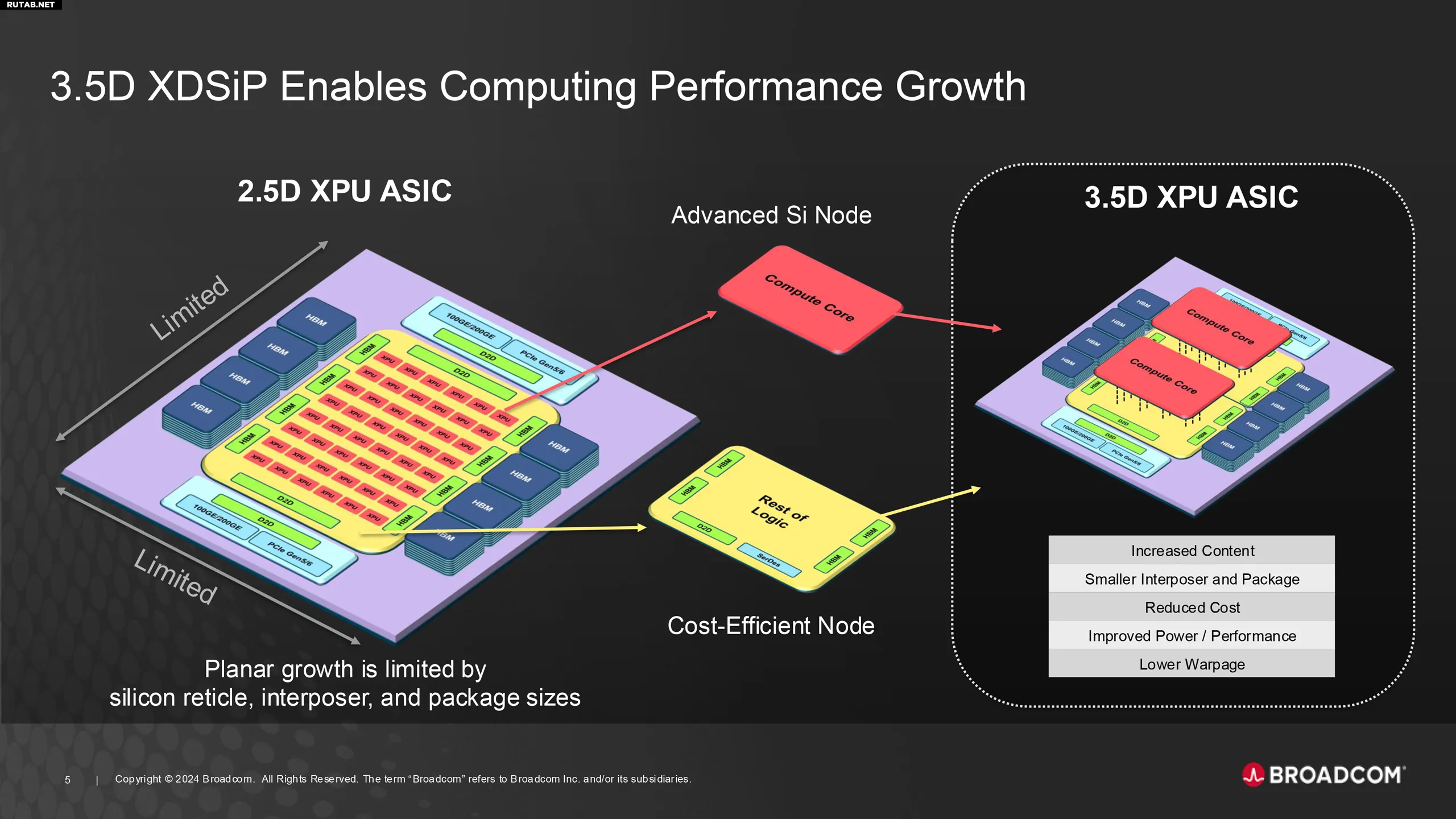
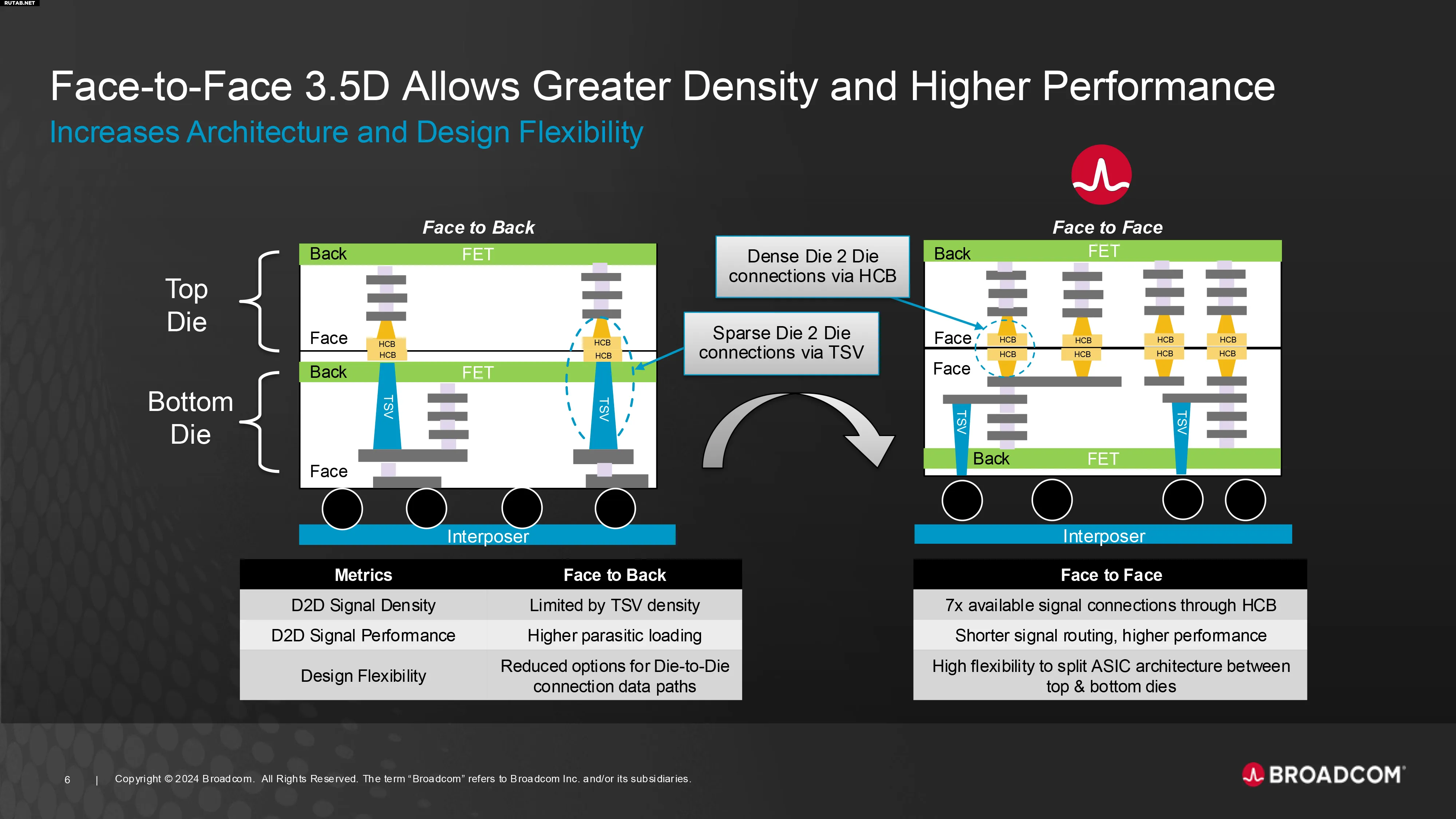
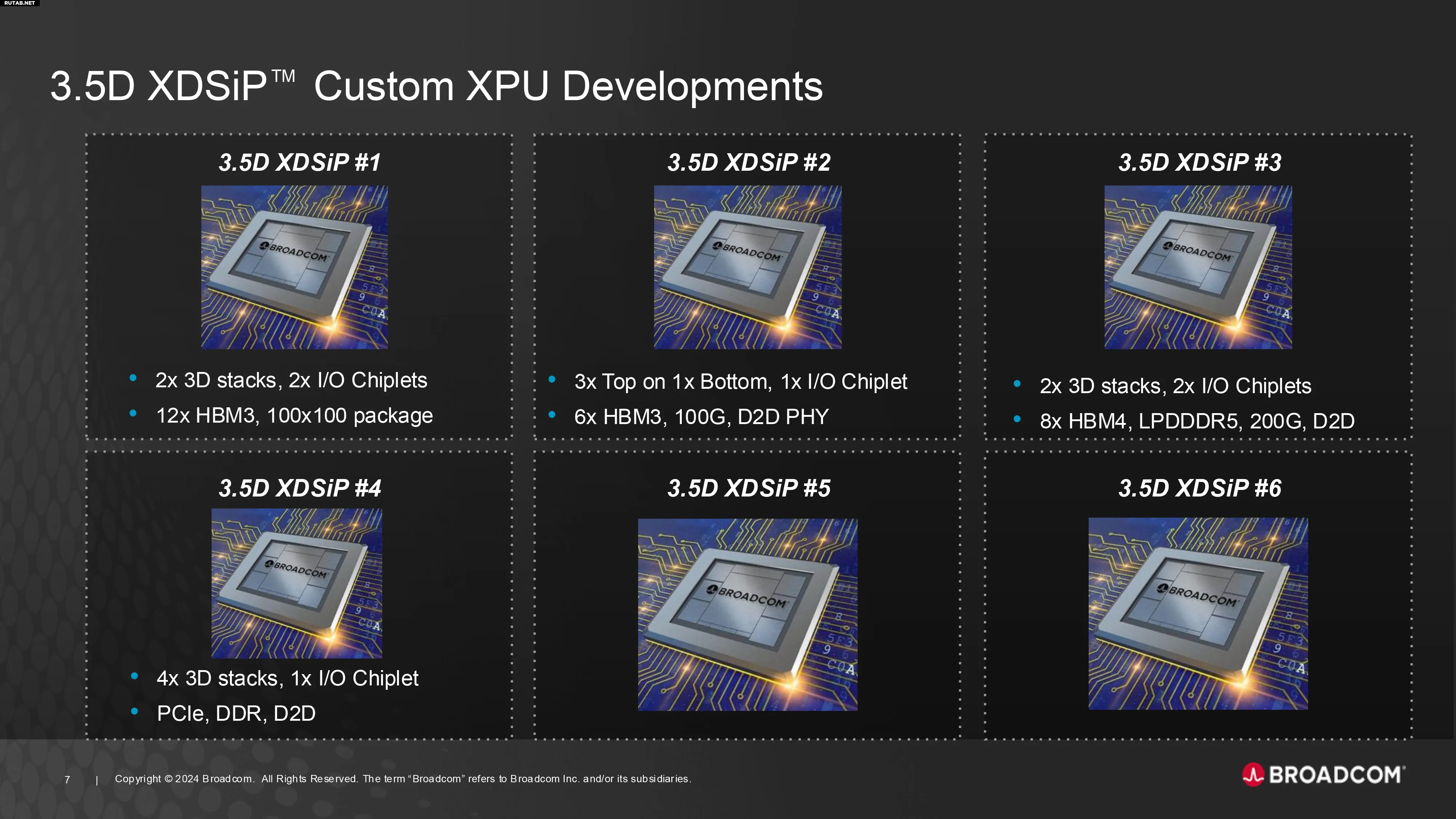







0 комментариев