TSMC представляет дорожную карту технологий упаковки в масштабе пластин и более крупных пакетов ИИ
 TSMC (аббревиатура от англ. Taiwan Semiconductor Manufacturing Company) — тайваньская компания, занимающаяся изучением и производством полупроводниковых изделий. Основана в 1987 году правительством Китайской республики и частными инвесторами.
Штаб-квартира TSMC находится в г. Википедия
TSMC (аббревиатура от англ. Taiwan Semiconductor Manufacturing Company) — тайваньская компания, занимающаяся изучением и производством полупроводниковых изделий. Основана в 1987 году правительством Китайской республики и частными инвесторами.
Штаб-квартира TSMC находится в г. Википедия
Читайте также:Тайвань вводит новые ограничения на экспорт самых передовых технологических процессов TSMCTSMC отказывается от литографии с высокой числовой апертурой для разработки узла A14TSMC раскрывает плотность дефектов N2 — ниже, чем N3 на той же стадии разработкиSK hynix представила HBM4 на симпозиуме TSMC 2025TSMC планирует выпуск сверхмощных процессоров
Интегрированный разветвитель, или InFO, добавляет еще одно измерение с гибкими 3D-сборками. Оригинальный мост InFO уже работает на картах AMD Instinct. Позже в этом году появятся InFO-POP (package-on-package) и InFO-2.5D, обещающие еще более плотную укладку чипов и открывающие новый потенциал масштабирования в одном корпусе, отходя от привычной нам упаковки 2D и 2.5D, переходя в третье измерение. В масштабе пластин линейка System-on-Wafer от TSMC — SoW-P и SoW-X — выросла из специализированных движков ИИ в комплексную дорожную карту, отражающую прогресс логических узлов. В этом году отмечены первые стеки SoIC от N3 до N4, с каждой плиткой до 830 мм² и без жесткого ограничения на размер верхнего кристалла. Эта траектория указывает на массивные, сверхплотные корпуса, которые именно то, что будет востребовано в центрах обработки данных HPC и ИИ в ближайшие годы.
Источник: HardwareLuxx

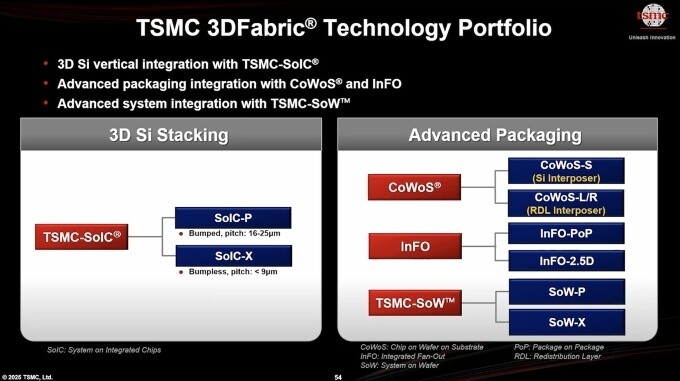
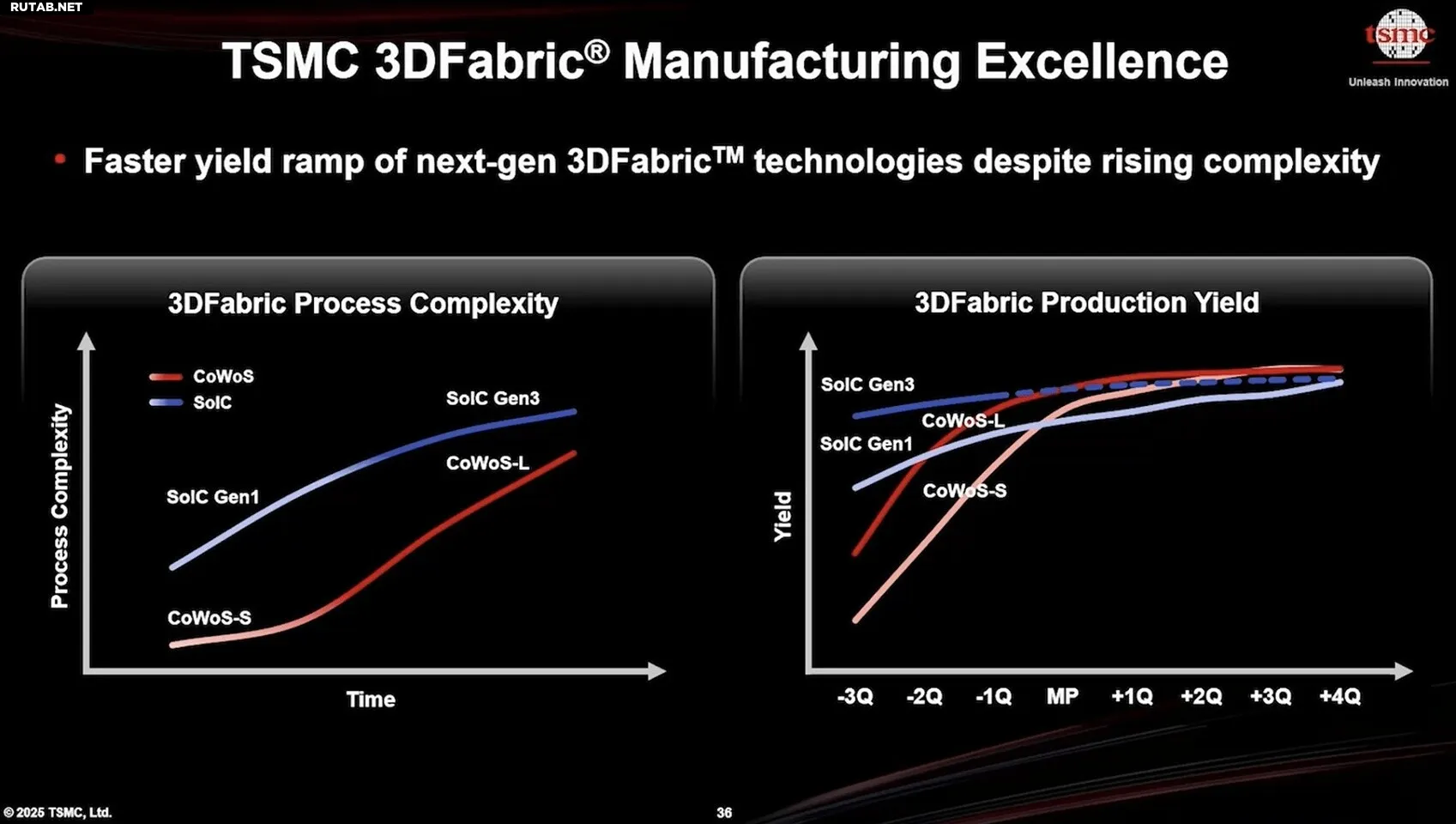
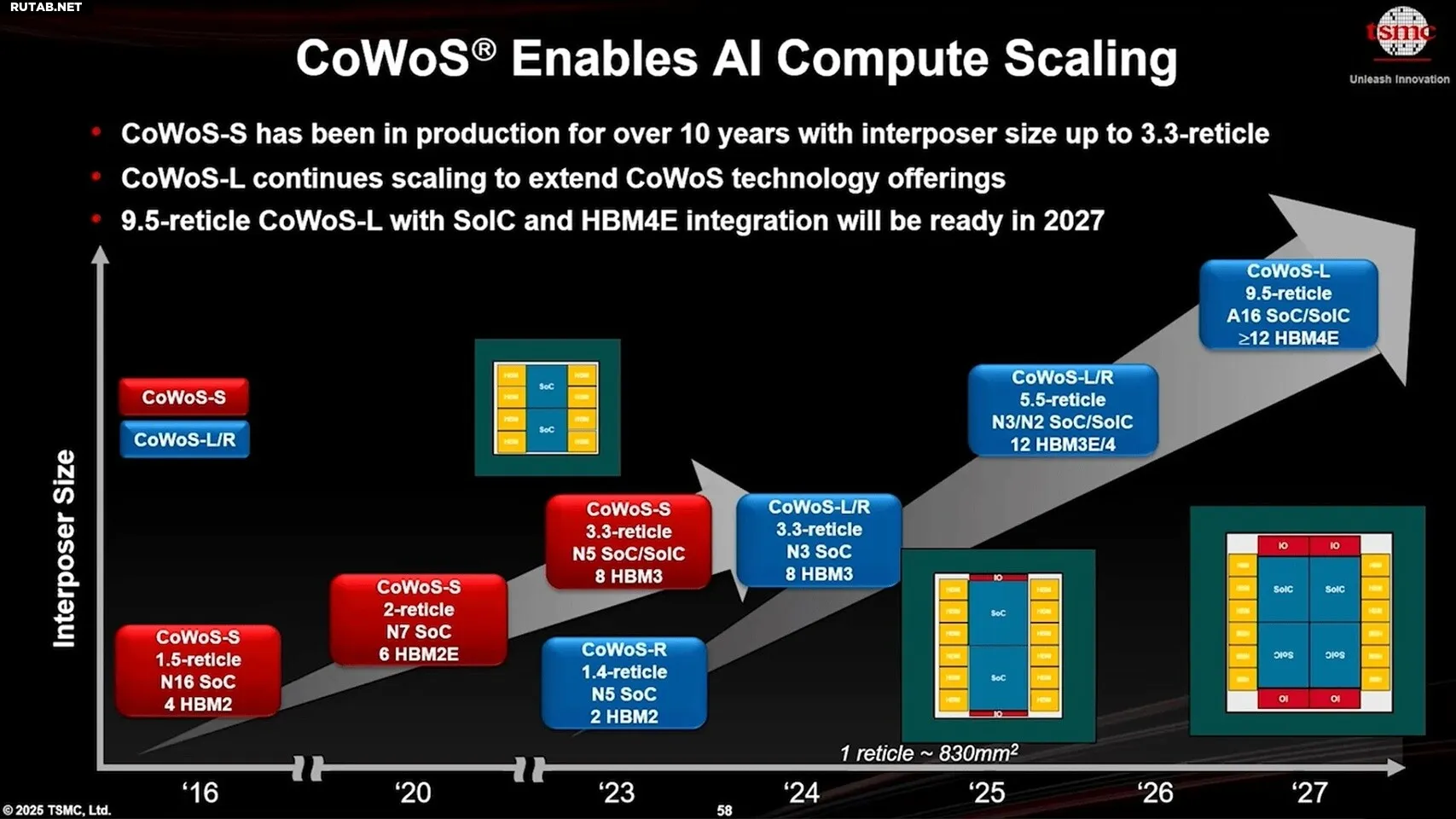







0 комментариев