ASML совершила прорыв в технологии EUV-литографии, планирует увеличить скорость на 50% к 2030 году
Голландская компания ASML, ключевой поставщик оборудования для производства полупроводников, на этой неделе подтвердила, что находится на пути к созданию системы литографии Twinscan NXE с источником экстремального ультрафиолетового (EUV) излучения мощностью 1000 Вт. Новая установка сможет обрабатывать до 330 пластин в час, что на 50% больше, чем у текущего флагмана — NXE:3800E. Ожидается, что это позволит значительно повысить производительность и снизить стоимость производства чипов. Внедрение системы запланировано на 2030 год или позже.
«То, что было достигнуто — один киловатт — это довольно удивительно», — заявил Майкл Пурвис, ведущий технолог ASML по источникам EUV-излучения, в интервью Reuters. — «Мы видим достаточно ясный путь к 1500 ваттам, и нет фундаментальных причин, почему мы не могли бы добраться до 2000 ватт».
Современные EUV-сканеры генерируют излучение, воздействуя на микроскопические капли олова импульсами CO₂-лазера. Для достижения мощности в 1000 Вт ASML пришлось удвоить количество капель олова до 100 000 в секунду и производить две последовательности лазерных импульсов вместо одной. Ранее компания подала патентную заявку на источник света, производящий три последовательности импульсов.
Установка нового генератора капель и лазерной системы с удвоенной производительностью — это лишь часть задачи. Увеличение числа капель означает и рост количества побочных продуктов, которые могут осесть на пластине, что потребовало разработки совершенно новой системы сбора мусора. Кроме того, для передачи усиленного излучения на пластину были изобретены новые высокопроницательные проекционные оптические системы, уже используемые в модели NXE:3800E и рассчитанные на масштабирование до более чем 450 пластин в час. Также для работы с источником в 1000 Вт потребуются новые фоторезисты и защитные мембраны (пелликулы), поэтому к инновациям ASML должна подготовиться вся отрасль.
ASML ещё предстоит интегрировать новый источник в свои дорожные карты для систем с низкой (Low-NA) и высокой (High-NA) числовой апертурой. Следующее поколение Low-NA системы, Twinscan NXE:4000F с производительностью более 250 пластин в час, ожидается в 2027 году. На фронте High-NA EUV в следующем году планируется выпуск Twinscan EXE:5200C с производительностью более 185 пластин в час.
ИИ: Прогресс ASML в увеличении мощности EUV-источников — это критически важный шаг для поддержания закона Мура и производства более совершенных и доступных чипов. Успех в достижении заявленных мощностей к 2030 году может определить технологическое лидерство целых стран и корпораций в следующем десятилетии.

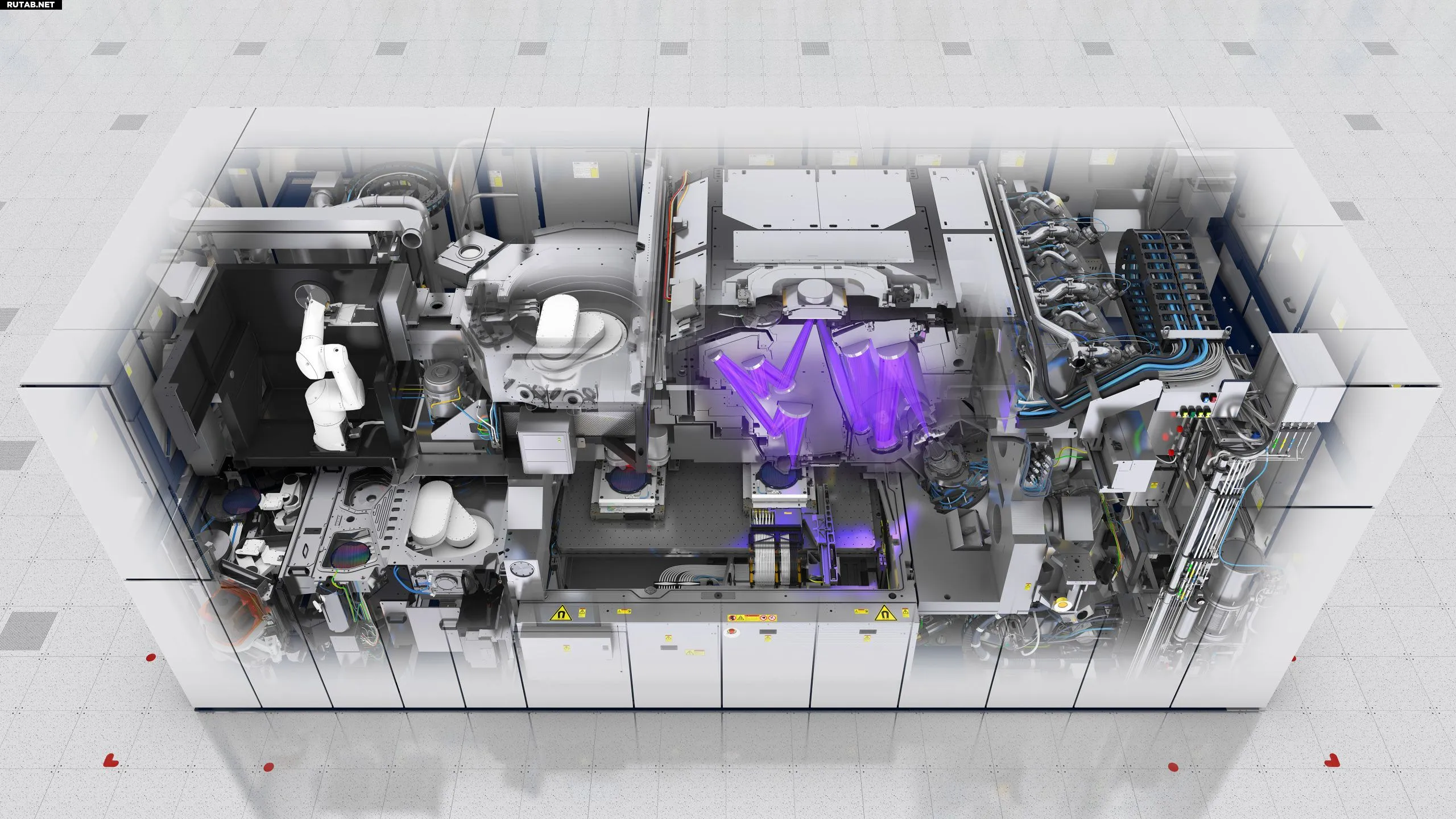
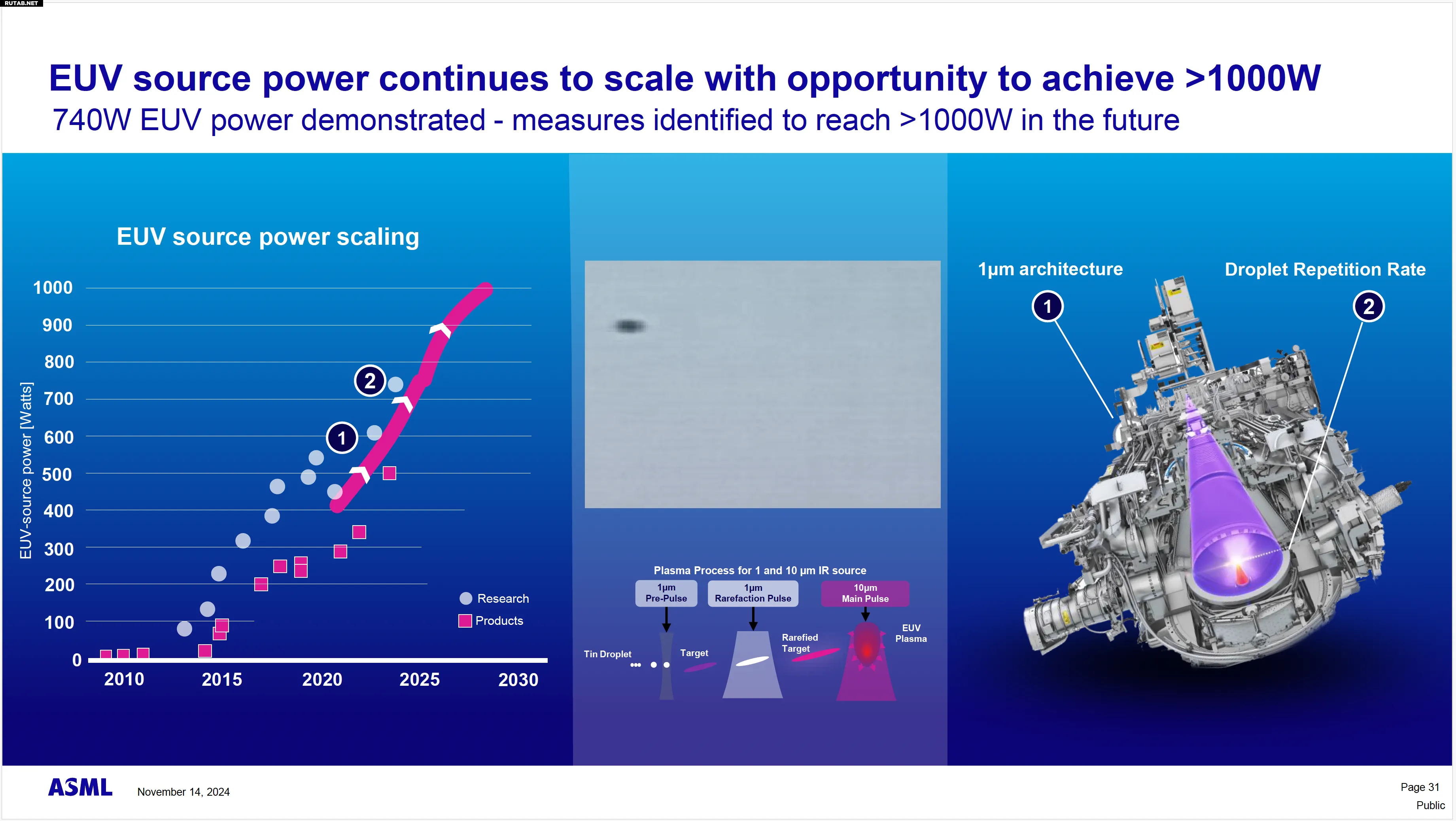
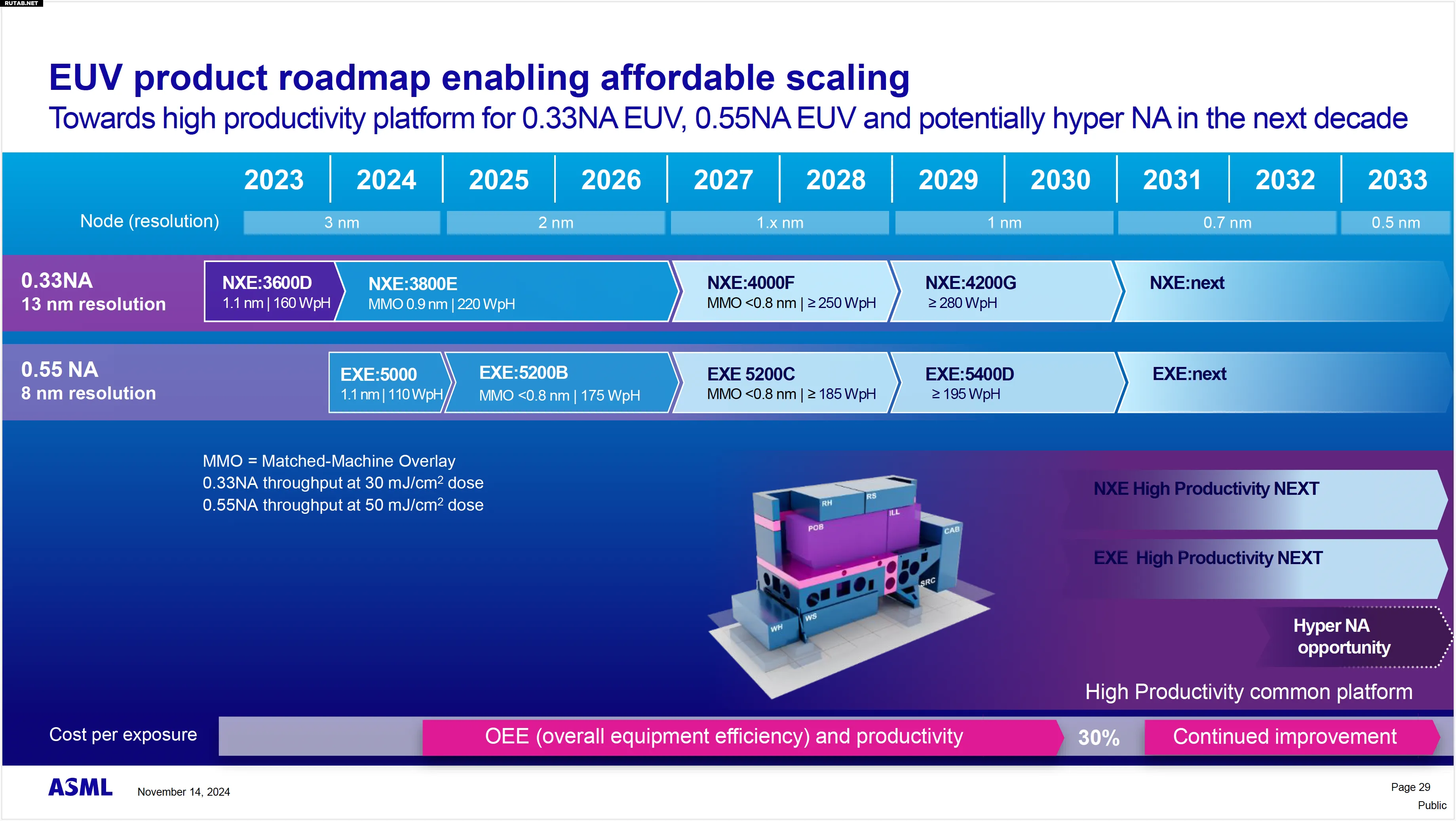






0 комментариев