Японские компании наращивают производство материалов для 2-нанометровых чипов
По мере того как производство чипов по 2-нанометровому техпроцессу выходит на стадию массового выпуска, японские поставщики материалов наращивают мощности по выпуску фоторезистов и высокочистых химикатов для EUV-литографии, сообщает Nikkei. Компании Tokyo Ohka Kogyo (TOK), Adeka и JSR строят или модернизируют предприятия по производству фоторезистов и металлооксидных резистов (MOR), которые улучшают разрешение, шероховатость краёв линий и стойкость к травлению для экстремального ультрафиолетового формирования схем.
TOK инвестирует 20 млрд иен (~2,6 млрд рублей) в строительство завода по производству фоторезистов в Южной Корее (запуск намечен на 2030 год), что увеличит мощности в три-четыре раза для таких клиентов, как Samsung, TSMC и SK hynix. Отдельно компания вложит 12 млрд иен (~1,56 млрд рублей) в площадку для производства высокочистых химикатов для полупроводников. Эти химикаты (растворители, проявляющие растворы, поверхностно-активные вещества, чистящие средства) критически важны для EUV-процессов, где чувствительность резиста, контроль загрязнений и ограничения по газовыделению напрямую влияют на выход годных пластин и срок службы масок.
Инвестиции Adeka в размере 3,2 млрд иен (~416 млн рублей) позволят оснастить её линии в Ибараки для массового производства MOR (примерно с апреля 2028 года), в то время как объект JSR по производству MOR в Южной Корее должен быть запущен к концу 2026 года.
Эти расширения позволяют устранить узкие места, характерные для технологии EUV-литографии, такие как компромисс между чувствительностью резиста и разрешением, снижение дефектов и контроль загрязнений. Японские поставщики уже занимают большую часть рынка высококачественных фоторезистов (около 91% доли рынка), что даёт им преимущество перед конкурентами, которые улучшили технологию i-line/KrF резистов, но всё ещё отстают в масштабировании производства EUV MOR и химикатов процессного класса. MOR содержат металлические соединения, которые увеличивают поглощение EUV-фотонов и улучшают перенос рисунка: более высокое поглощение снижает требования к дозе облучения, а металлосодержащие составы могут обеспечить лучшую шероховатость краёв линий и стойкость к травлению по сравнению с традиционными органическими резистами, что является ключевым фактором для точности формирования схем на уровнях менее 2 нм.
Источник: Nikkei

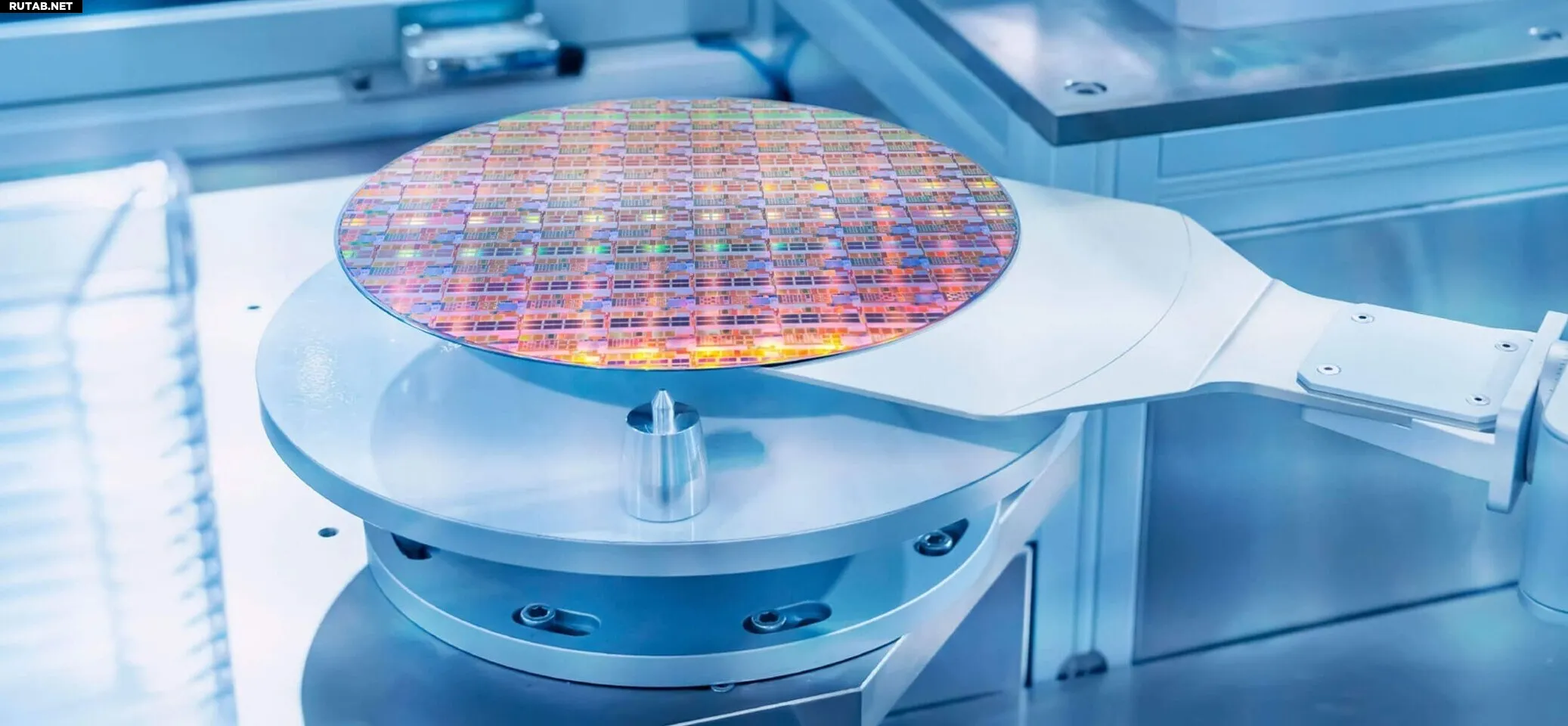






0 комментариев