Ученые впервые измерили свойства отдельных частиц MXene
Исследование микроскопических частиц MXene с помощью поляризованного света для выявления их оптических, структурных и транспортных свойств. Авторы: Ралфи Кеназ и Андреас Фурхнер
Международная группа исследователей впервые измерила истинные свойства отдельных частиц MXene — перспективного наноматериала для создания улучшенных аккумуляторов, гибкой электроники и устройств чистой энергии.
С помощью новой световой методики, называемой спектроскопической микроэллипсометрией, ученые обнаружили, как MXenes ведут себя на уровне отдельных частиц. Это выявило изменения проводимости и оптического отклика, которые ранее были скрыты при изучении только слоистых структур.
MXenes — это ультратонкие материалы толщиной в несколько атомов, известные своей способностью проводить электричество, накапливать энергию и взаимодействовать со светом. До сих пор большинство исследований изучали MXenes в объемной форме — как тонкие пленки из множества перекрывающихся частиц.
Доктор Андреас Фурхнер из Центра Гельмгольца в Берлине и доктор Ралфи Кенац из Еврейского университета в Иерусалиме разработали методику, позволяющую измерять оптические, структурные и электронные свойства отдельных частиц MXene с высоким разрешением без их повреждения.
«Мы можем напрямую измерить оптические свойства, толщину, структурные характеристики и проводимость отдельных частиц MXene менее чем за минуту — все это неразрушающим способом», — заявил доктор Кенац.
Исследователи обнаружили, что по мере уменьшения толщины частиц MXene их электрическое сопротивление увеличивается — критически важное понимание для создания надежных высокопроизводительных устройств.
Метод оказался настолько точным, что соответствовал результатам наномасштабных методов визуализации, таких как атомно-силовая микроскопия и просвечивающая электронная микроскопия.
MXenes исследуются для широкого спектра применений — от сверхбыстрых аккумуляторов и систем очистки воды до гибкой электроники и сбора солнечной энергии. Понимание поведения материала на уровне отдельных частиц необходимо для проектирования эффективных и масштабируемых устройств.
Исследование было опубликовано в журнале ACS Nano и устанавливает спектроскопическую микроэллипсометрию в качестве нового стандарта для анализа двумерных материалов.

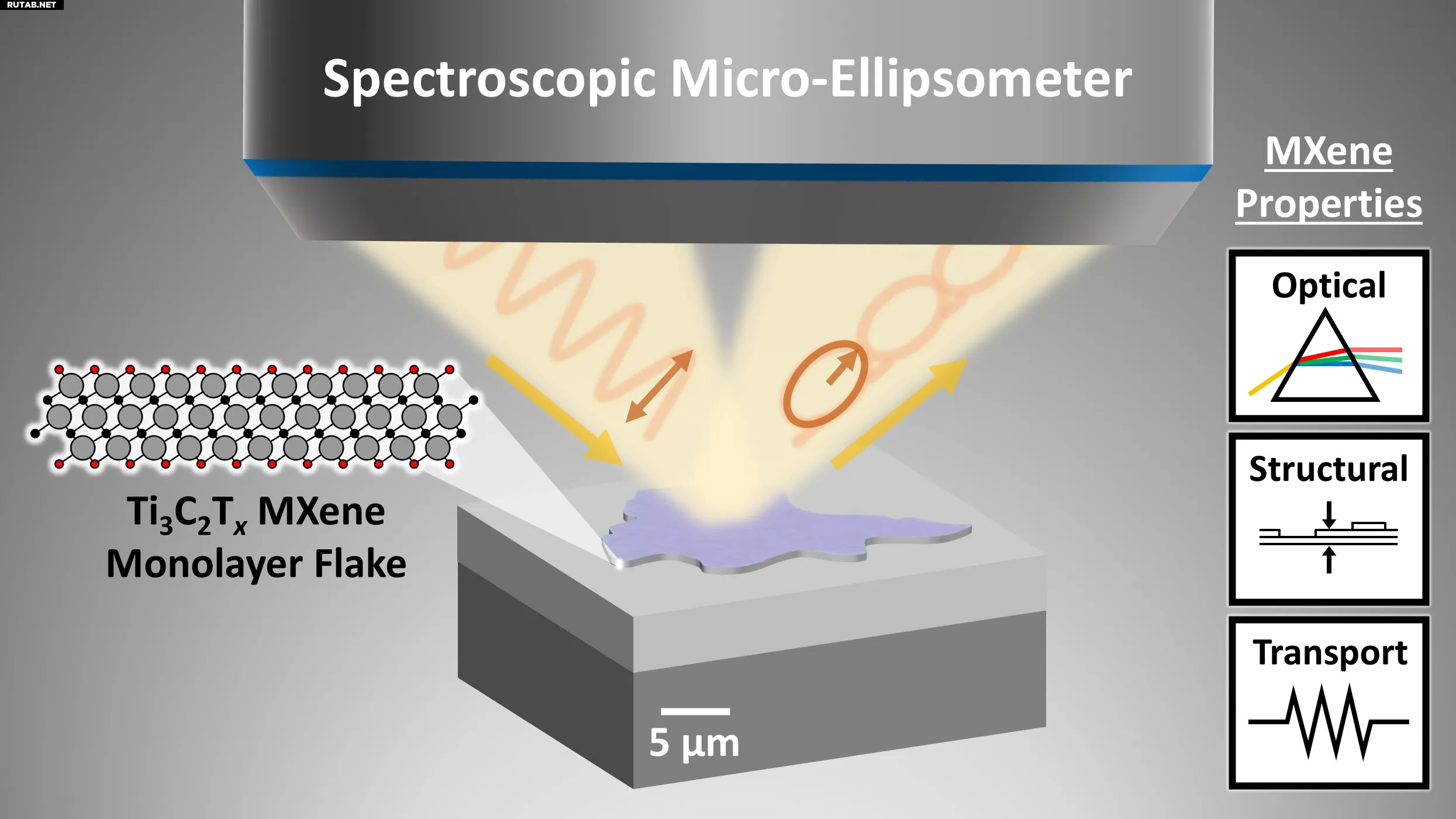






0 комментариев