Американский ответ доминированию в полупроводниках: упаковка чипов от Intel
Администрация президента Трампа активно работает над созданием передового производства чипов на территории США. В этой гонке осталось лишь несколько ключевых игроков: Intel, Samsung и тайваньская TSMC, которая стала лидером отрасли благодаря продвинутому производству и упаковке чипов.
Хотя Intel исторически сталкивалась с трудностями в производстве самых современных чипов и даже передавала часть заказов TSMC, у компании появилась возможность стать крупным партнером по упаковке чипов для многих производителей, включая саму TSMC.
Проблема в том, что пластины, производимые на заводе TSMC в Аризоне, отправляются обратно на Тайвань для упаковки, что нарушает цель создания независимой цепочки поставок. Intel же с начала 2024 года расширила свои мощности в Нью-Мексико, создав первую массовую производственную линию для передовой 3D-упаковки, расположенную в одном месте для полного цикла изготовления.
Услуги передовой упаковки от Intel Foundry
Портфолио Intel Foundry включает технологии 2D, 2.5D и 3D упаковки, позволяющие оптимизировать стоимость, энергопотребление и пропускную способность. Технология EMIB представляет собой кремниевый мост, встроенный в подложку, обеспечивающий высокую плотность соединений между кристаллами без дорогостоящего кремниевого интерпозитора.
Варианты EMIB предоставляют гибкость разработчикам чипов. Например, чип «Ponte Vecchio» использует EMIB 3.5D для объединения более 100 миллиардов транзисторов, 47 активных блоков и пяти технологических процессов на одном кристалле. Этот продукт, питающий суперкомпьютер Aurora, доказал, что Intel способна предоставлять самые передовые решения по упаковке в ответственных проектах.
Что касается самих чипов, технологический процесс Intel 18A и его будущие вариации станут долгоживущими узлами. Финансовый директор Дэвид Зинснер заявил: «Мы еще не достигли пика поставок для 18A. Фактически, мы достигнем его только к концу десятилетия. Мы считаем, что этот узел будет для нас довольно долгоживущим».
Однако настоящее преимущество Intel начнется с процесса 14A — первого в отрасли, использующего оборудование High-NA EUV. Компания сообщила об обработке более 30 000 пластин за квартал с помощью High-NA EUV, что упростило производство, сократив необходимое количество шагов для определенного слоя с 40 до менее 10.
TSMC планирует сотрудничать с компанией Amkor, которая строит в Аризоне предприятие стоимостью 7 миллиардов долларов (~560 миллиардов рублей) для аутсорсинга упаковки и тестирования чипов. Производство на новом объекте должно начаться в начале 2028 года. Тем временем Intel может предложить свою передовую упаковку EMIB партнерам, включая клиентов TSMC.
Источник: Techpowerup.com

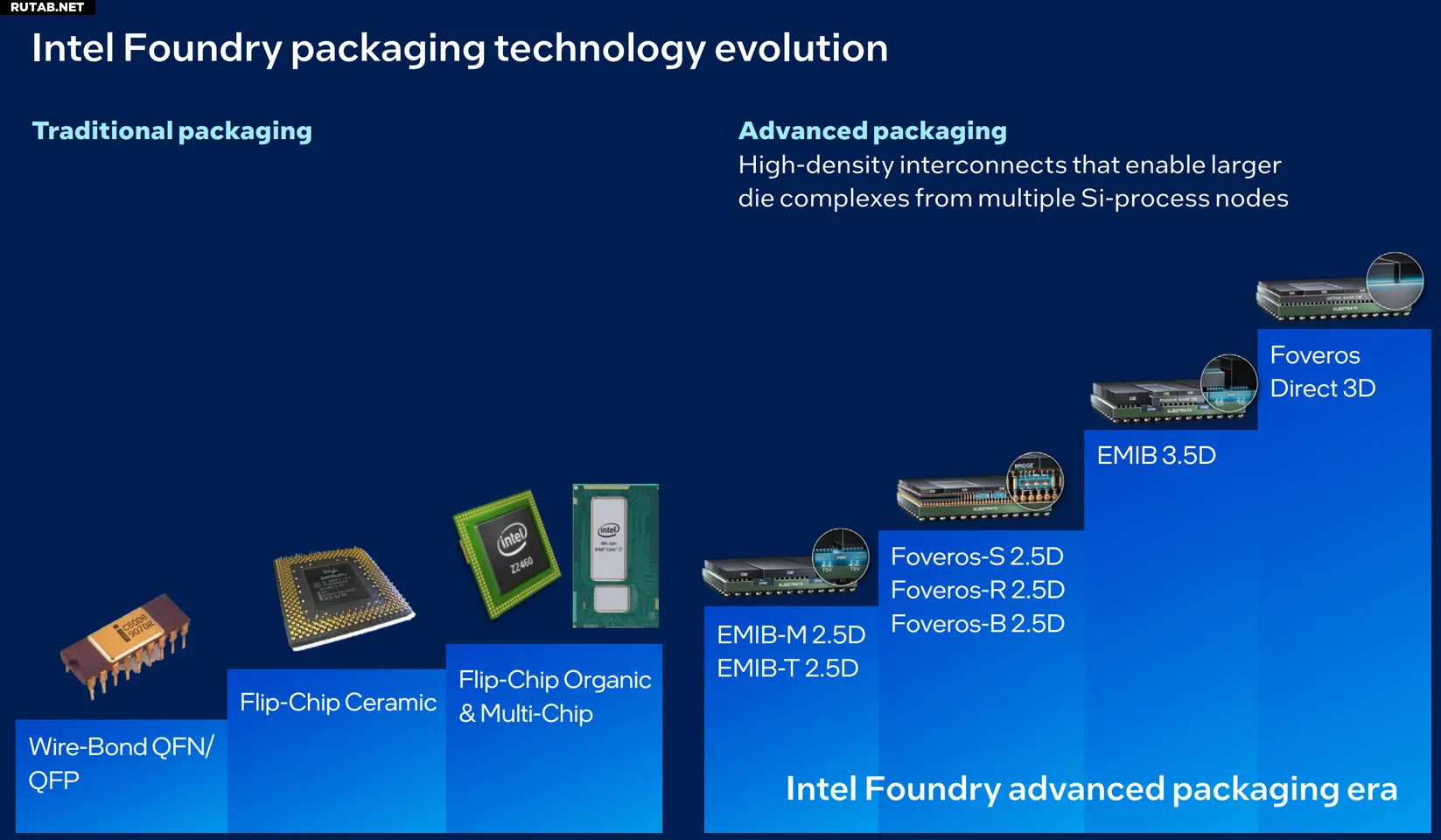
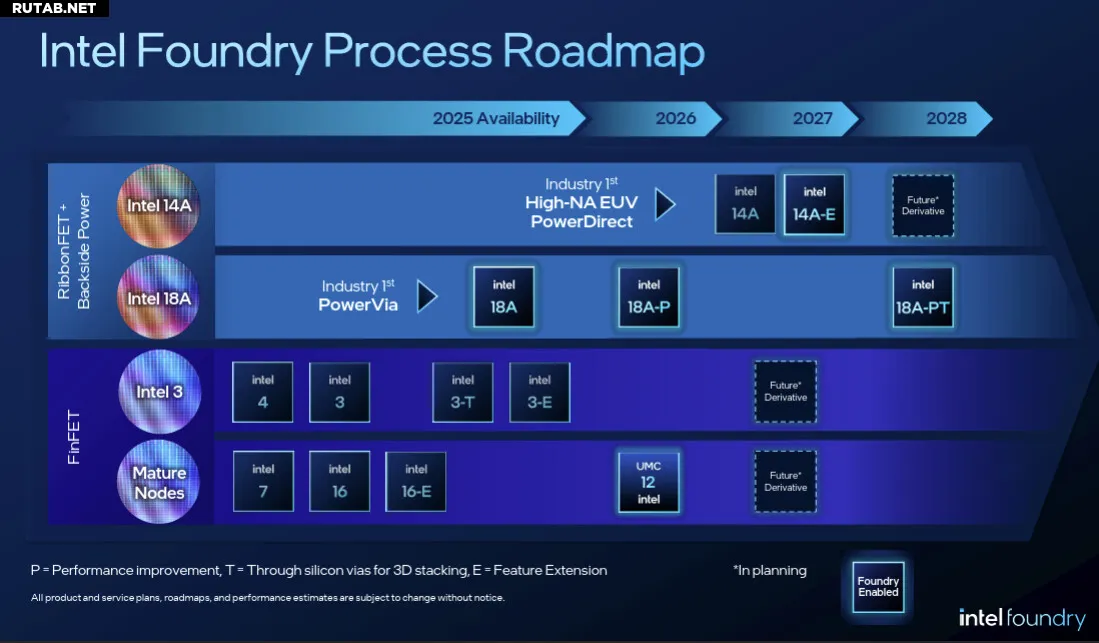
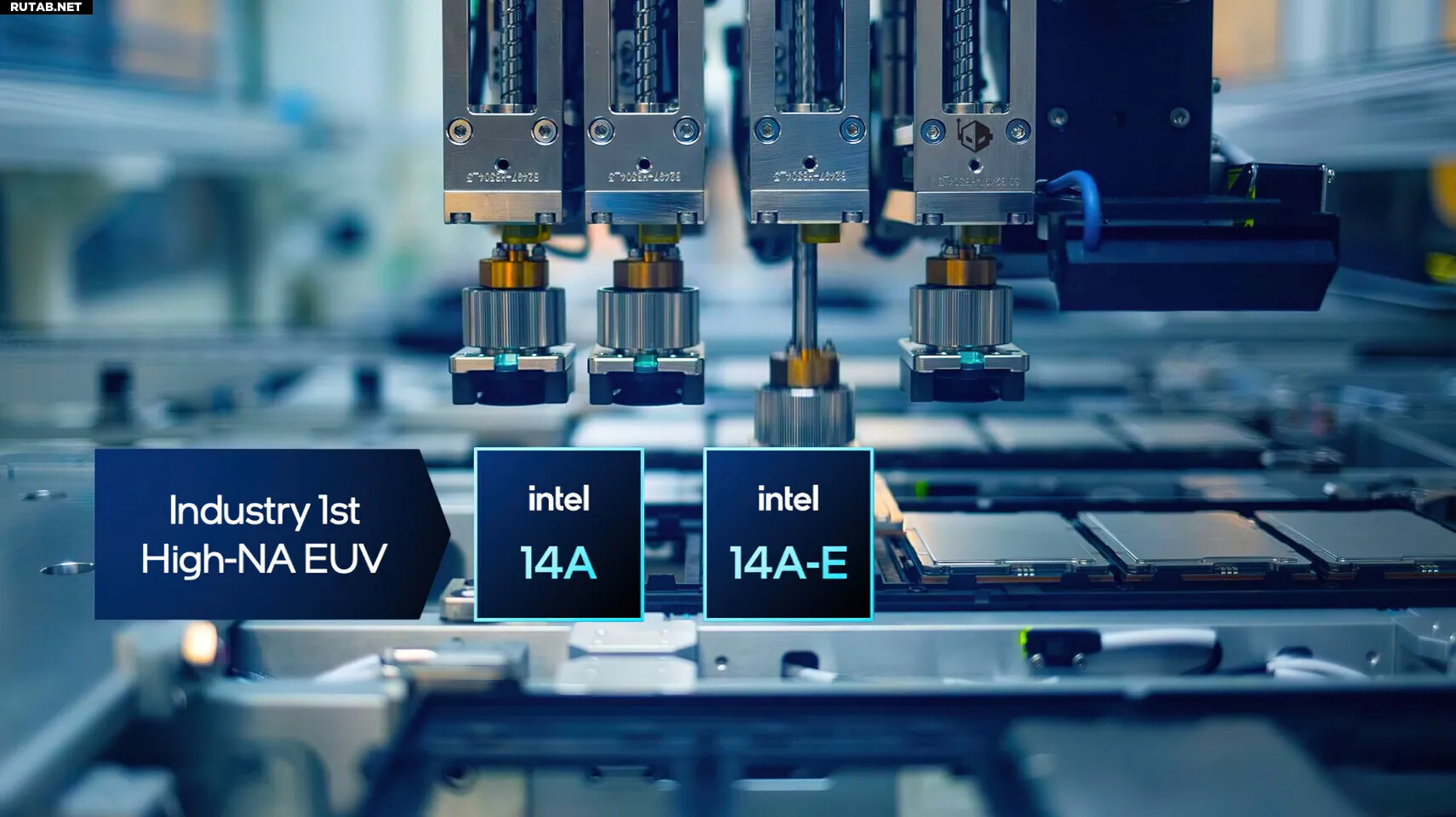
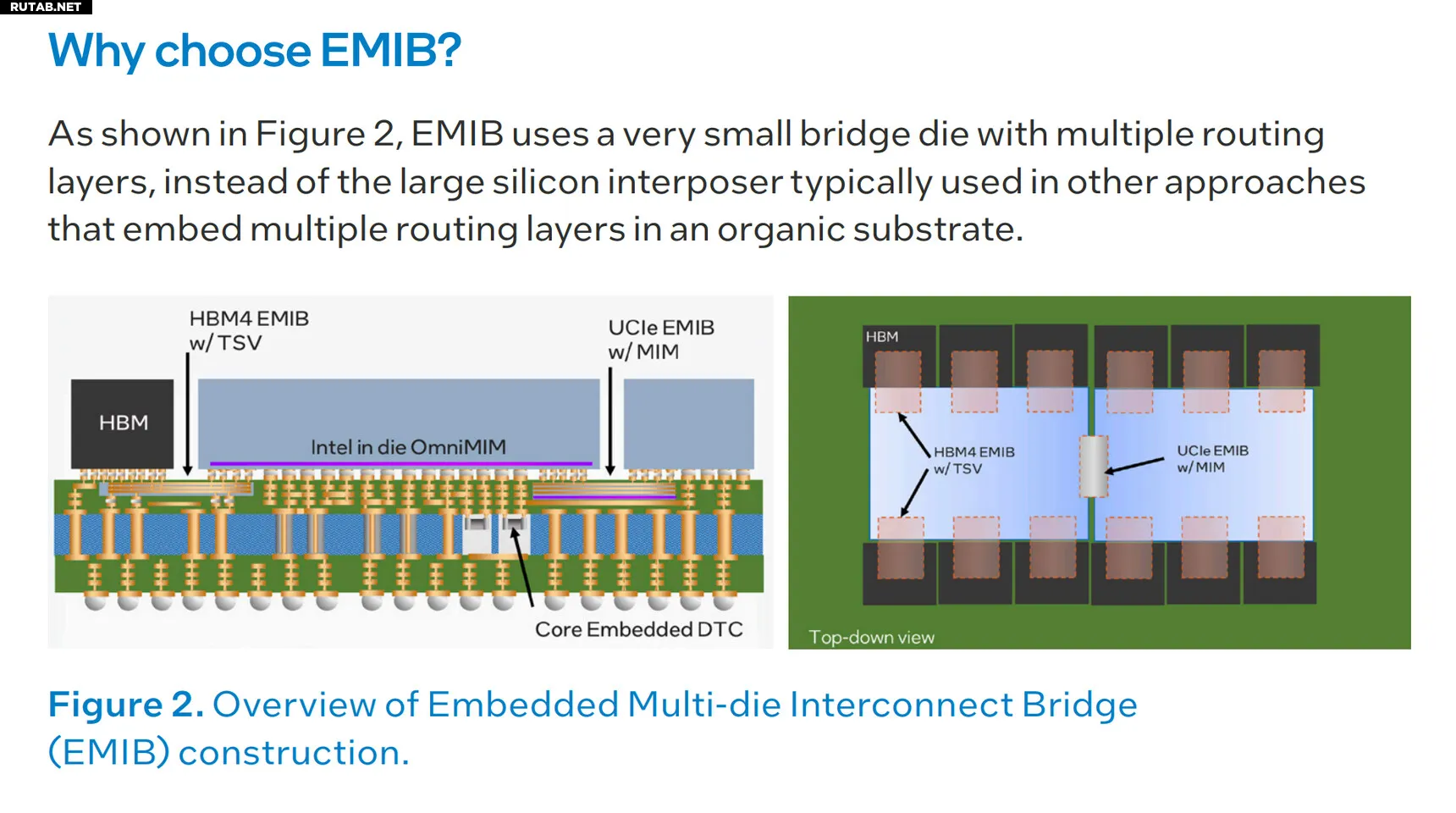






0 комментариев