Intel представила прорывные технологии упаковки чипов: EMIB-T, новые системы охлаждения и термокомпрессионное соединение
Компания Intel представила несколько прорывных технологий упаковки чипов на конференции Electronic Components Technology Conference (ECTC). Среди ключевых новинок — технология EMIB-T, новая конструкция теплораспределителя и усовершенствованный метод термокомпрессионного соединения.
(Изображение: Intel)
(Изображение: Tom's Hardware)
(Изображение: Tom's Hardware)
(Изображение: Tom's Hardware)
EMIB-T: мощность и пропускная способность
EMIB-T — это эволюция технологии EMIB, которая теперь включает сквозные кремниевые переходы (TSV). Это позволяет улучшить подачу питания и увеличить скорость связи между чиплетами. Технология особенно важна для работы с памятью HBM4/4e и интерфейсом UCIe-A, обеспечивая скорость передачи данных до 32 Гбит/с и выше.
(Изображение: Intel)
Новые решения для охлаждения
Intel также представила новую конструкцию теплораспределителя, разделённого на плоскую пластину и усилитель. Это улучшает теплопередачу и снижает количество пустот в термоинтерфейсе на 25%. Кроме того, компания разработала систему жидкостного охлаждения, интегрированную непосредственно в теплораспределитель, что позволяет эффективно охлаждать чипы с TDP до 1000 Вт.
(Изображение: Intel)
Термокомпрессионное соединение
Новый метод термокомпрессионного соединения решает проблему деформации подложки и кристаллов во время производства. Это повышает надёжность и позволяет создавать более крупные чипсеты.
(Изображение: Intel)
(Изображение: Intel)
(Изображение: Intel)
(Изображение: Intel)
(Изображение: Intel)
(Изображение: Intel)
ИИ: Эти инновации демонстрируют, что Intel продолжает активно развивать технологии упаковки чипов, что критически важно в условиях растущей конкуренции с TSMC. Особенно впечатляет потенциал EMIB-T для работы с памятью HBM4 и высокоскоростными интерфейсами — это может дать Intel преимущество в сегменте высокопроизводительных вычислений.
Источник: Tomshardware.com

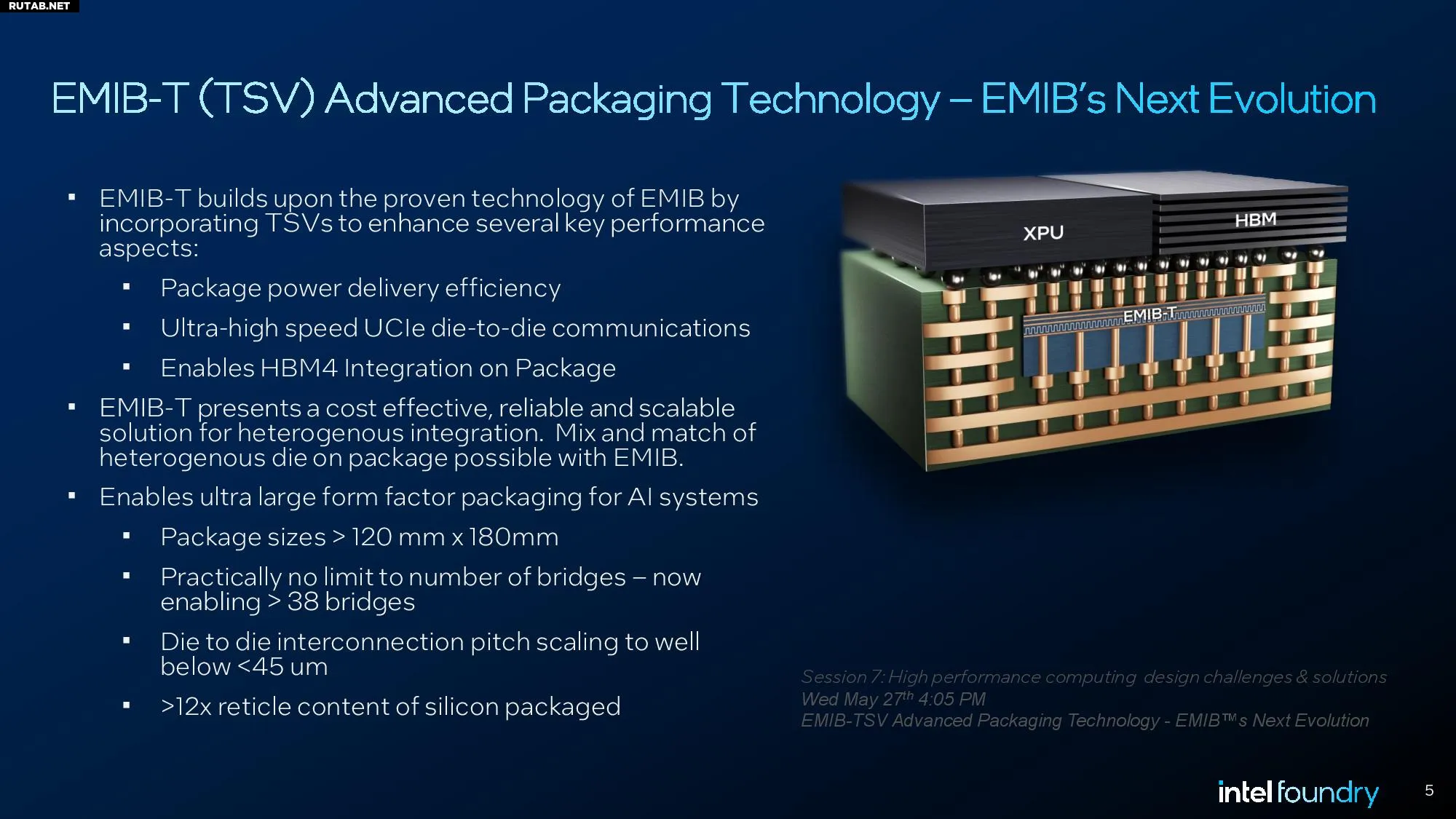
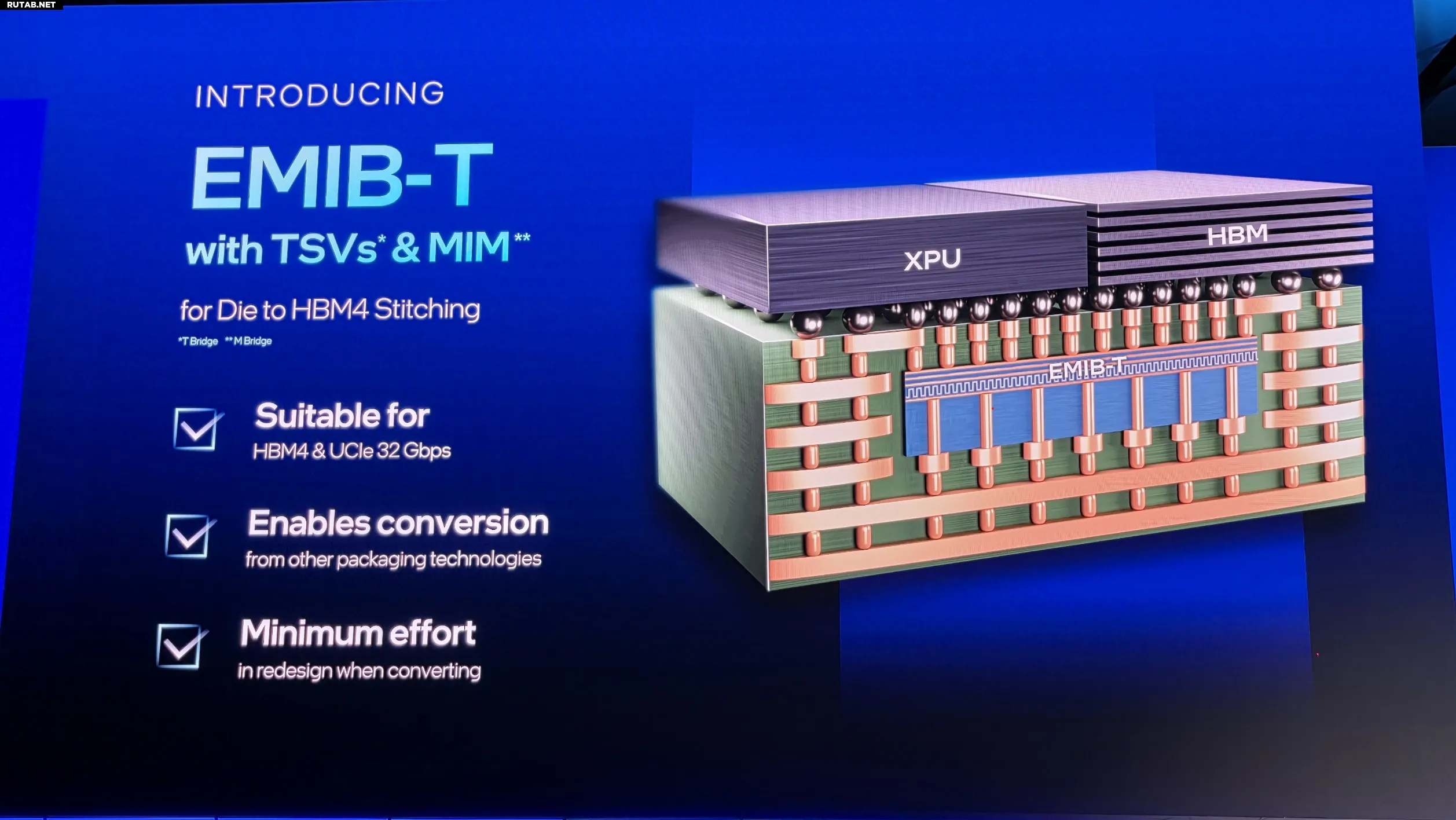
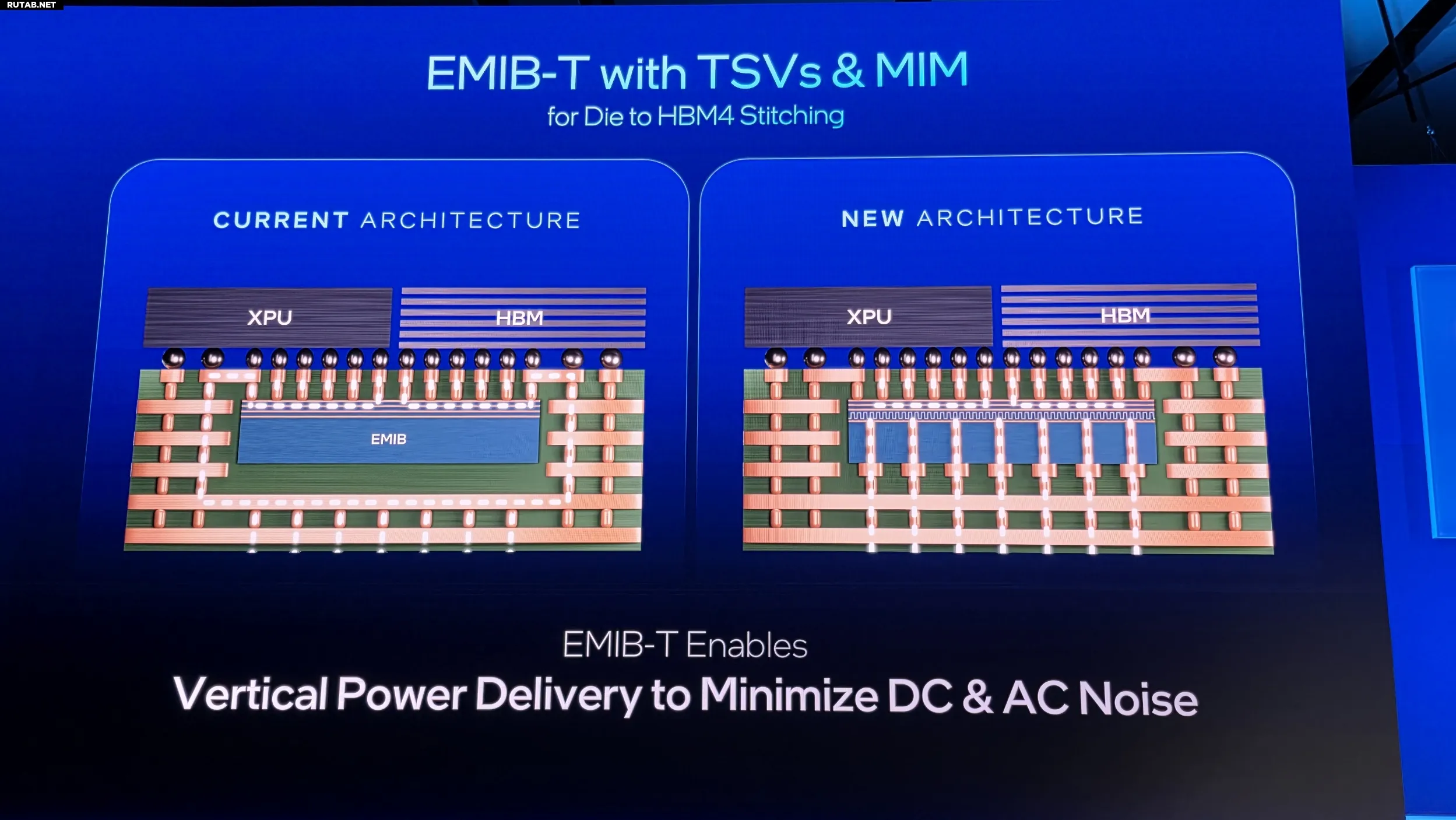
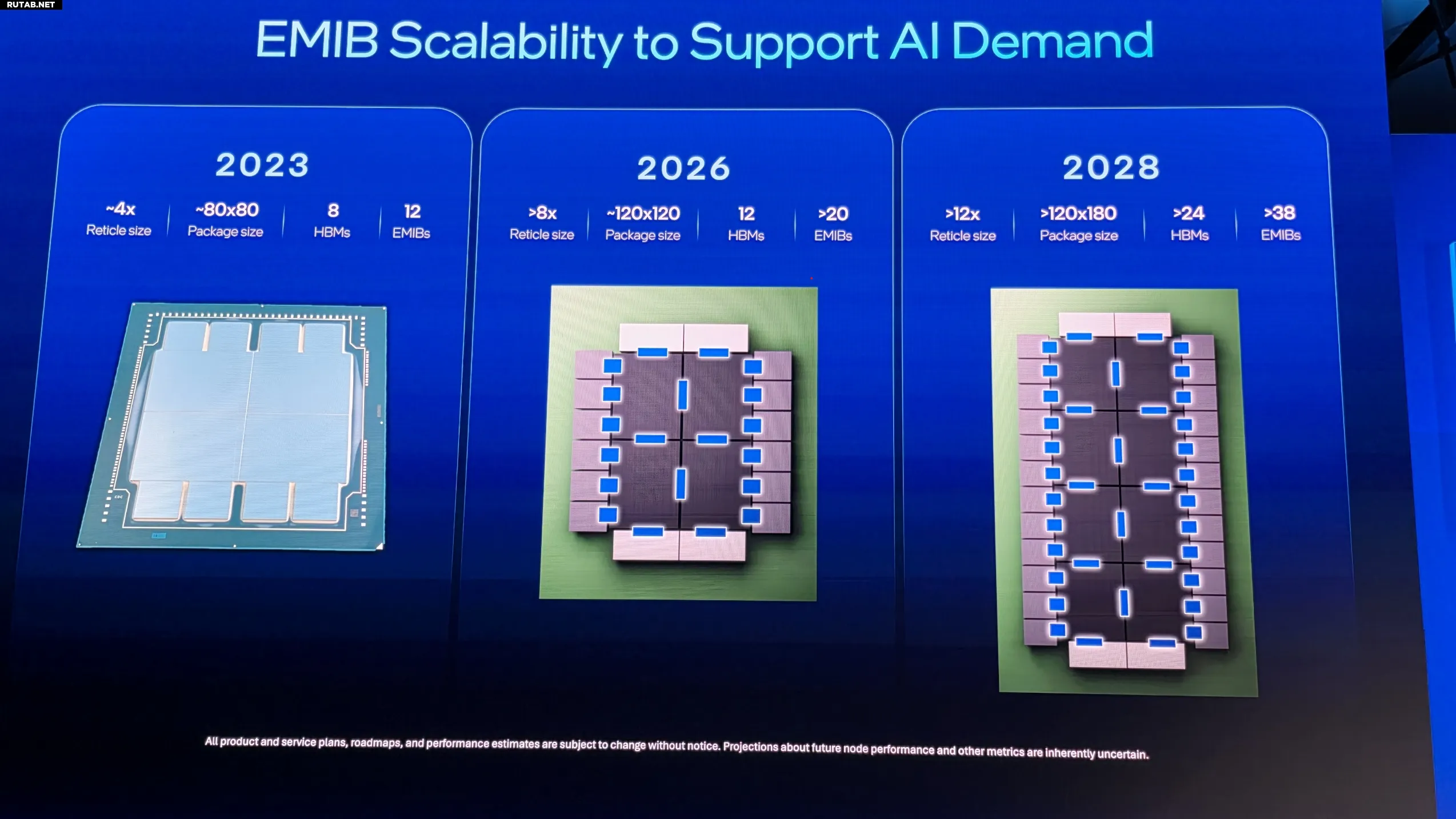
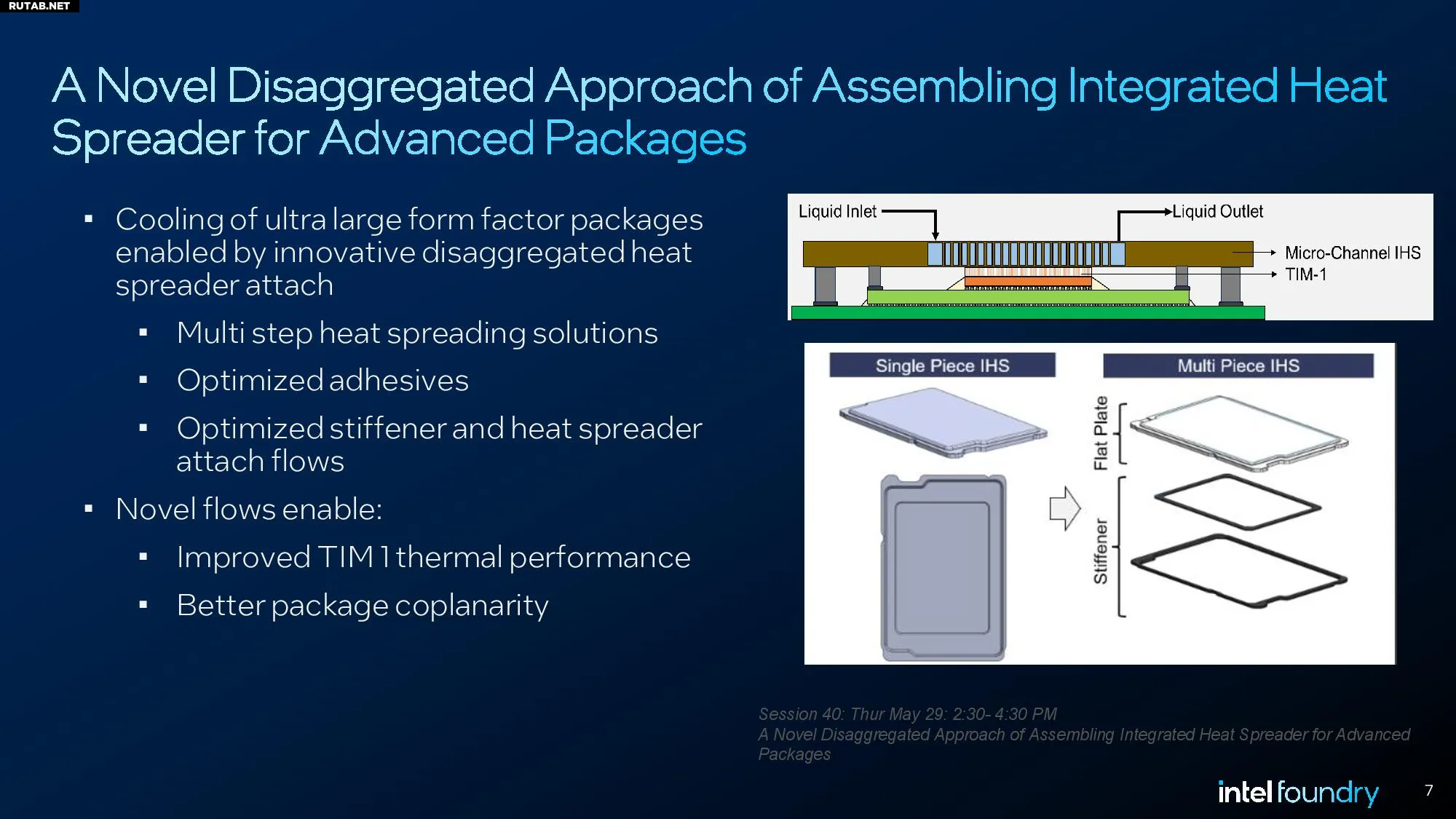
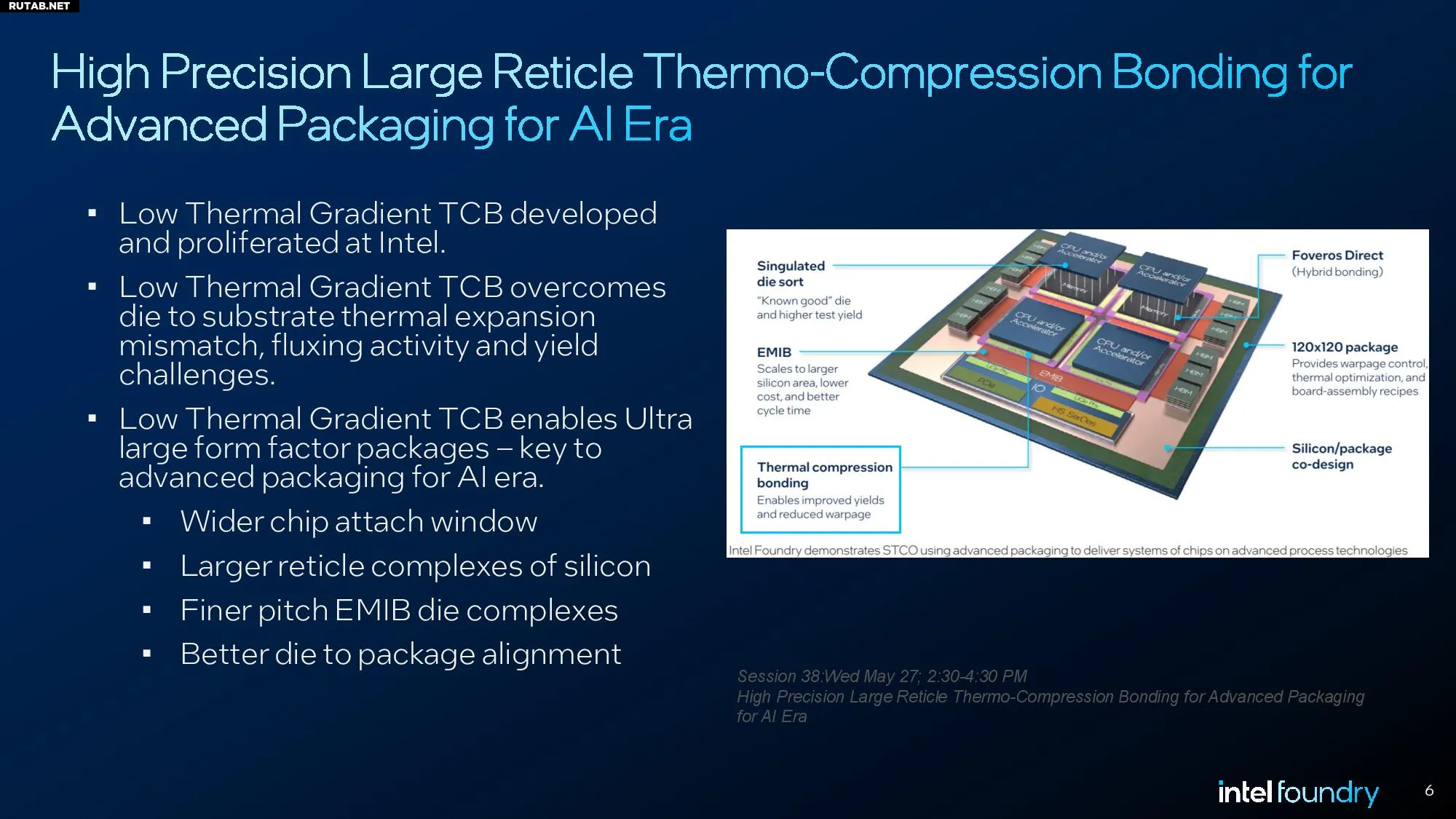












0 комментариев