Стек HBM5 20hi будет использовать технологию гибридного склеивания
TrendForce сообщает, что внимание к продуктам HBM в отрасли DRAM все больше переключается на передовые технологии упаковки, такие как гибридное склеивание. Крупные производители HBM рассматривают возможность внедрения гибридного склеивания для продуктов HBM4 16hi stack, но подтвердили планы по внедрению этой технологии в поколение HBM5 20hi stack.
Гибридное соединение дает несколько преимуществ по сравнению с более широко используемым микро-бампингом. Поскольку оно не требует выступов, оно позволяет размещать больше слоев и может вмещать более толстые чипы, что помогает бороться с короблением. Гибридно-связанные чипы также выигрывают от более быстрой передачи данных и улучшенного рассеивания тепла.
TrendForce указывает, что три основных производителя продолжат использовать архитектуры стекирования Advanced MR-MUF и TC-NCF для стека HBM3e 12hi и стека HBM4 12hi. Между тем, четкое предпочтение стеку HBM4 16hi и стеку HBM4e 16hi еще не проявилось между гибридным связыванием и микро-бампингом, поскольку гибридное связывание в настоящее время не имеет существенных преимуществ перед микро-бампингом.
Если производители выберут гибридное склеивание, то, скорее всего, им придется освоить кривую обучения этой новой технологии укладки на ранней стадии, чтобы обеспечить более плавное массовое производство продуктов HBM4e и HBM5 в будущем. Производители подтвердили, что гибридное склеивание будет использоваться в поколении стеков HBM5 20hi после учета ограничений по высоте стека, плотности ввода-вывода и управлению температурой.
Однако гибридное склеивание сопряжено с рядом проблем. Например, производители, инвестирующие в новое оборудование для внедрения технологии, снизят свою зависимость от микростолкновений, тем самым потеряв все накопленные преимущества в этой области.
Гибридное склеивание также представляет технические проблемы, такие как контроль частиц, что может привести к увеличению удельных инвестиционных затрат. Кроме того, гибридное склеивание требует укладки пластин к пластине, что может привести к неэффективности, если выход готовой продукции слишком низок и делает общее производство экономически нецелесообразным.
TrendForce отмечает, что принятие гибридного соединения может привести к значительным изменениям в бизнес-модели HBM. Становится критически важным гарантировать, что базовый кристалл и кристалл памяти имеют идентичные размеры чипа при укладке пластина к пластине. Поскольку проектирование базового кристалла в основном выполняется компаниями GPU/ASIC, TSMC, которая предлагает как базовые кристаллы, так и услуги по литейному производству GPU/ASIC, может взять на себя ответственность за укладку базового кристалла и кристалла памяти. Если такое развитие событий произойдет, это может существенно повлиять на роль производителей HBM в проектировании базовых кристаллов, укладке и общем управлении заказами HBM, что потенциально изменит конкурентную среду.
Источник: TrendForce

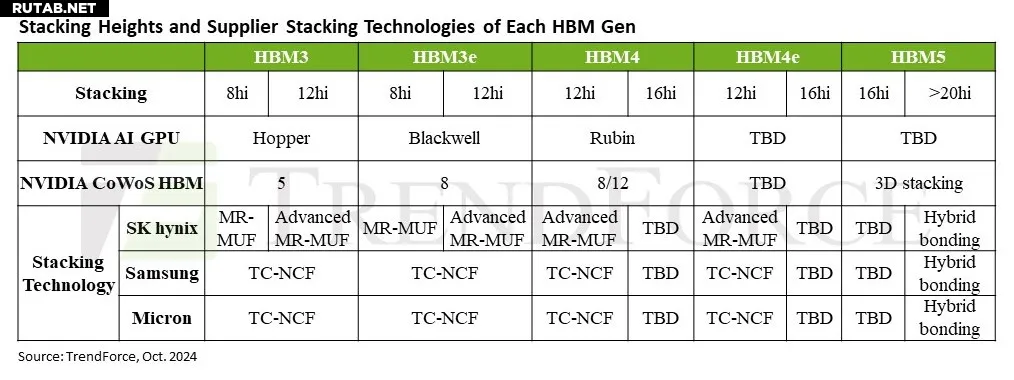






0 комментариев