DARPA инвестирует $1,4 млрд в создание 3D-процессоров
 Управле́ние перспекти́вных иссле́довательских прое́ктов Министе́рства оборо́ны США (англ. Defense Advanced Research Projects Agency, DARPA) — управление Министерства обороны США, отвечающее за разработку новых технологий для использования в интересах вооружённых сил. Задачей DARPA является сохранение технологического превосходства вооружённых сил США, предотвращение внезапного для США появления новых технических средств вооружённой борьбы, поддержка прорывных исследований, преодоление разрыва между фундаментальными исследованиями и их применением в военной сфере. Википедия
Управле́ние перспекти́вных иссле́довательских прое́ктов Министе́рства оборо́ны США (англ. Defense Advanced Research Projects Agency, DARPA) — управление Министерства обороны США, отвечающее за разработку новых технологий для использования в интересах вооружённых сил. Задачей DARPA является сохранение технологического превосходства вооружённых сил США, предотвращение внезапного для США появления новых технических средств вооружённой борьбы, поддержка прорывных исследований, преодоление разрыва между фундаментальными исследованиями и их применением в военной сфере. Википедия
 Соединённые Шта́ты Аме́рики (США), часто используется Соединённые Штаты или просто Америка (англ. United States of America, USA, U.S., America) — государство в Северной Америке. Площадь — 9,5 млн км² (4-е место в мире). Население — 325 млн человек (2016, оценка; 3-е место в мире). Википедия
Соединённые Шта́ты Аме́рики (США), часто используется Соединённые Штаты или просто Америка (англ. United States of America, USA, U.S., America) — государство в Северной Америке. Площадь — 9,5 млн км² (4-е место в мире). Население — 325 млн человек (2016, оценка; 3-е место в мире). Википедия
Читайте также:YMTC подает в суд на Micron в США, обвиняя Micron в нарушении 11 ее патентовПодавляющее большинство игроков в США соблазняются микротранзакциямиСША выстраивают цепочку поставок упаковки для чипсов в Латинской АмерикеСША устраняют критический пробел в цепочке поставок отечественного производства чиповСША планируют «драконовские» санкции против полупроводниковой промышленности Китая: отчет
Проект стоимостью 1,4 миллиарда долларов
Проект является частью программы DARPA Next Generation Microelectronics Manufacturing (NGMM), целью которой является разработка технологий 3D-упаковки и строительство соответствующих объектов для военного и гражданского использования. Проект предполагает инвестиции в размере 1,4 миллиарда долларов, при этом DARPA вложит 840 миллионов долларов, а Законодательное собрание Техаса вложит еще 552 миллиона долларов в TIE.
Это финансирование будет использовано для модернизации двух производственных предприятий UT, которые призваны способствовать внедрению инноваций двойного назначения в области интеграции нескольких чипсетов 3DHI как для оборонного сектора, так и для полупроводниковой промышленности. Эти объекты будут самоокупаемыми и доступными для научных кругов, промышленности (включая стартапы) и правительства.
Программа состоит из двух этапов, каждый продолжительностью 2,5 года. На первом этапе TIE сосредоточится на создании инфраструктуры и основных возможностей центра. Второй этап будет включать создание 3D-интегрированных (3DHI) прототипов оборудования, имеющих решающее значение для DoC, и автоматизацию различных процессов. Кроме того, TIE будет сотрудничать с DARPA по другим проектным задачам, финансируемым отдельно.
«Инвестируя в передовое производство микроэлектроники, мы помогаем защитить эту уязвимую цепочку поставок, повышаем нашу национальную безопасность и глобальную конкурентоспособность, а также стимулируем инновации в критически важных технологиях», — заявил сенатор США Джон Корнин. «Следующее поколение высокопроизводительных полупроводников, которые эти ресурсы позволят создать благодаря партнерству DARPA с UT TIE, поможет не только укрепить нашу оборону, но и проложит путь к тому, чтобы США вернули себе лидирующую роль в этой критически важной отрасли, и я с нетерпением жду возможности увидеть в ближайшие годы будет больше достижений Техаса».
3D-упаковка военного уровня
Современные военные приложения полагаются на несколько дискретных микросхем, что обычно усложняет эти системы и делает их более дорогими. Причина, по которой в реактивных самолетах или беспилотных летательных аппаратах используется много чипов, проста: каждый чип отвечает за определенное приложение (например, радар — это один мощный чип, изготовленный с использованием GaN, а помощь при прицеливании — это типичный высокопроизводительный чип, изготовленный на усовершенствованном кремниевом массиве). производственный процесс) и производится с использованием технологического процесса, который лучше всего подходит для данной конкретной рабочей нагрузки. В новом проекте будет предпринята попытка создать многочиплетные конструкции, которые объединят различную логику в один пакет и сделают этот пакет как можно меньшим. В результате эти системы в корпусах (SiP) позволят сделать военные устройства меньшего размера и более легкими.
Хотя большинство технологических процессов, предлагаемых такими компаниями, как Intel, GlobalFoundries или TSMC (теперь, когда они есть в США), достаточно хороши для многих применений, некоторые аэрокосмические и военные приложения требуют большей жесткости, поэтому специализированные технологические процессы по-прежнему будут использоваться. в использовании хотя бы некоторое время. Тем не менее, Intel 18A используется в некоторых военных приложениях, и это только начало выхода на эту нишу передовых узлов.
Когда дело доходит до технологий упаковки нескольких чипсетов, ситуация аналогичная. Передовые упаковочные технологии должны соответствовать авиационно-космическому и военному уровню, и они не должны выглядеть как «готовые» методы существующих производителей, отвечающие всем потребностям Министерства транспорта США. Именно здесь на помощь приходит программа NGMM DARPA, представленная в конце 2023 года.
Краткое содержание
В то время как сложные многочиптовые процессоры повысят национальную безопасность США и глобальное военное лидерство, лаборатории и производственные мощности в Техасе, созданные в рамках проекта, будут доступны также разработчикам и производителям гражданских приложений, что означает потенциальный стимул для научных инноваций. и промышленная мощь США.
Источник: Tomshardware.com

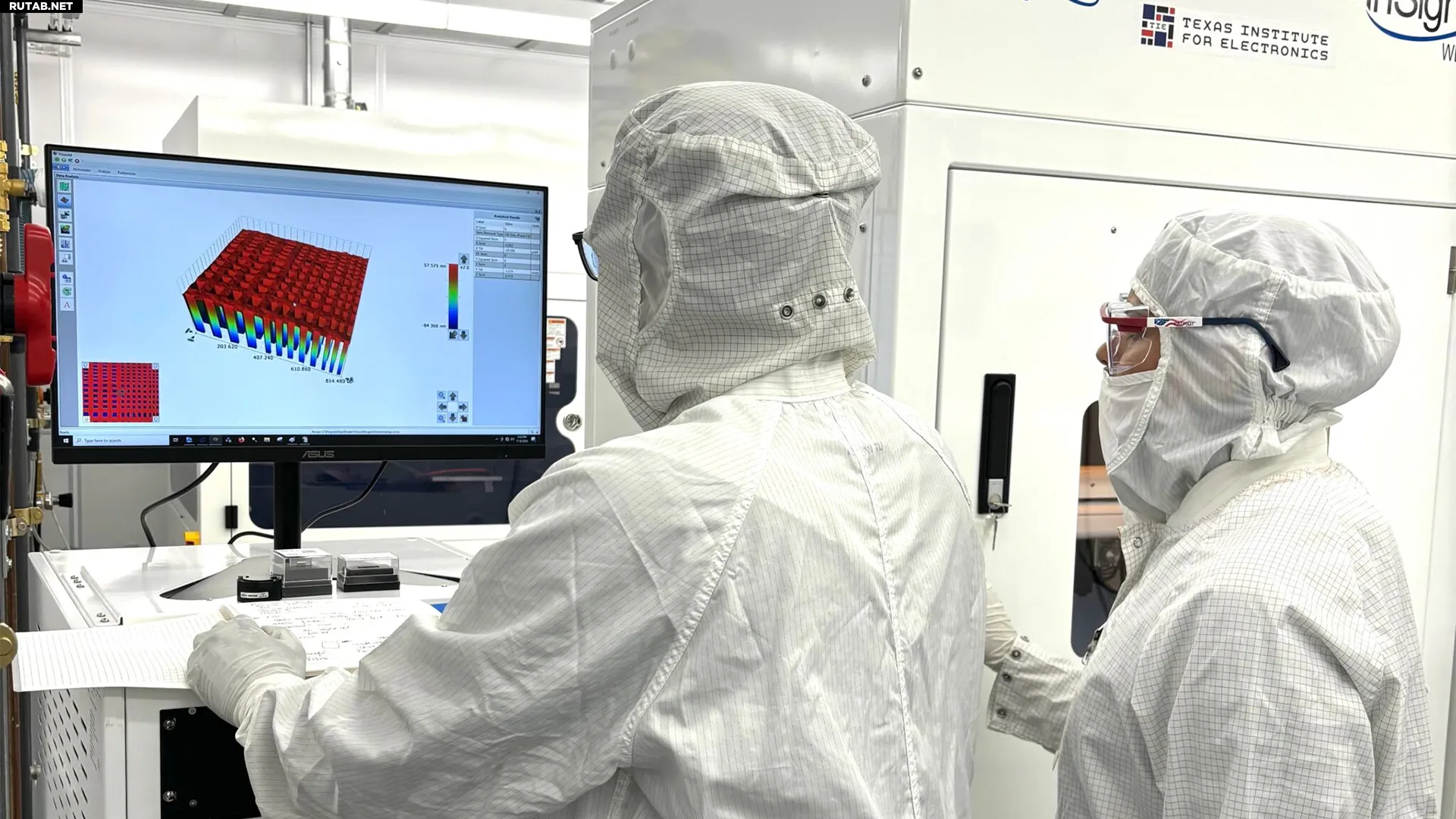






0 комментариев